SEM을 이용한 표면 성분분석(EDS)과 XPS 분석의 차이
대표적인 표면 원소분석 방법인 EDS와 XPS의 차이점 비교
포스팅 개요
EDS 분석과 XPS 분석은 표면의 성분 원소를 분석할 때 자주 활용하는 장비입니다. 2가지 모두 X-ray와 관련된 원리를 활용해 표면의 원소에 대해 정성분석과 정량분석이 가능하다는 점에서 유사한 점이 있습니다.
이런 유사성으로 인해서 많은 분들이 2가지 분석의 차이점에 대해 궁금해하시는 경우가 많은데요. 이번 포스팅에서는 EDS와 XPS 두 가지 분석 방법의 차이에 대해서 알아보는 시간을 가지도록 하겠습니다.
EDS와 XPS는 정확히 어떤 점이 다를까요?
EDS와 XPS는 모두 X-ray를 이용한 분석 기술이지만 활용 방법이 다르고, 그로 인해 분석 범위와 결과에 있어서도 차이가 있습니다. 먼저 EDS부터 X선을 어떻게 활용하는지 살펴보겠습니다.
EDS의 X-ray 활용 원리
EDS는 SEM의 전자건에서 전자빔을 시료 표면에 주사하였을 때 발생하는 X선을 분석합니다. 이때 고에너지 전자빔이 시료 표면에 충돌하면 시료 표면으로부터 비교적 깊은 부분에서도 X선이 발생하게 되는데요. 이런 상호작용으로 인하여 EDS 분석 시 표면에서부터 약 3um 깊이의 성분에 대한 정보까지도 얻을 수 있다고 알려져 있습니다.
그렇기 때문에 나노미터 단위의 표층에 대한 성분 분석에는 다소 부적합한 부분이 있지요.
또한 분석 깊이는 가속 전압뿐만 아니라 표면의 원소 종류에 따라 달라질 수 있어요. 그래서 분석 깊이에 대한 정보를 명확히 파악하기에 어려움이 있어 정밀한 정량 분석은 한계가 있습니다.
그렇지만 성분 검출을 이미지와 함께 직관적으로 확인할 수 있다는 강력한 장점이 있어 이미지와 함께 빠르게 분석을 해야 한다면 아주 좋은 선택이 될 수 있습니다.
전자빔으로 인한 X선의 발생
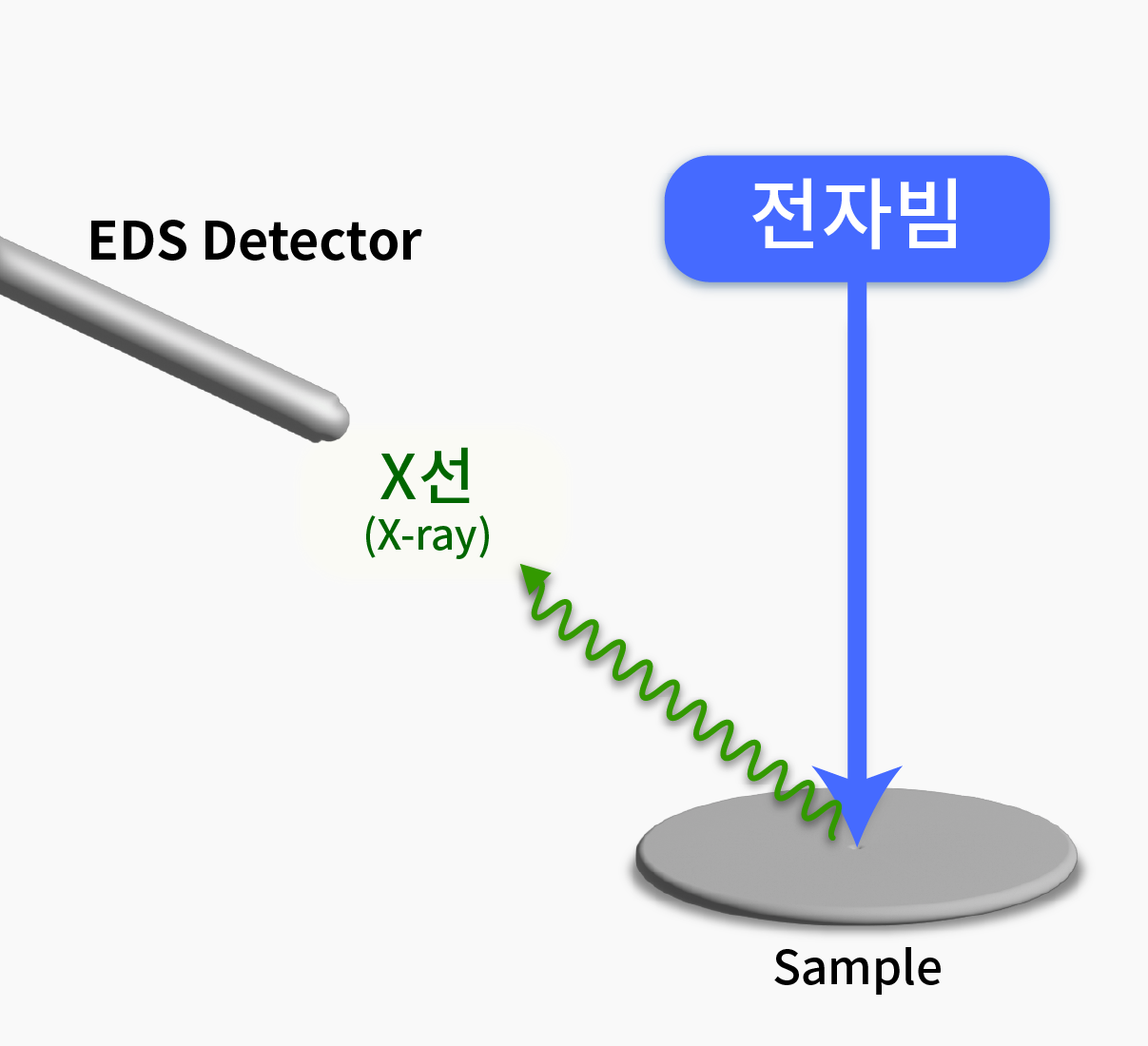
방출되는 X선 영역
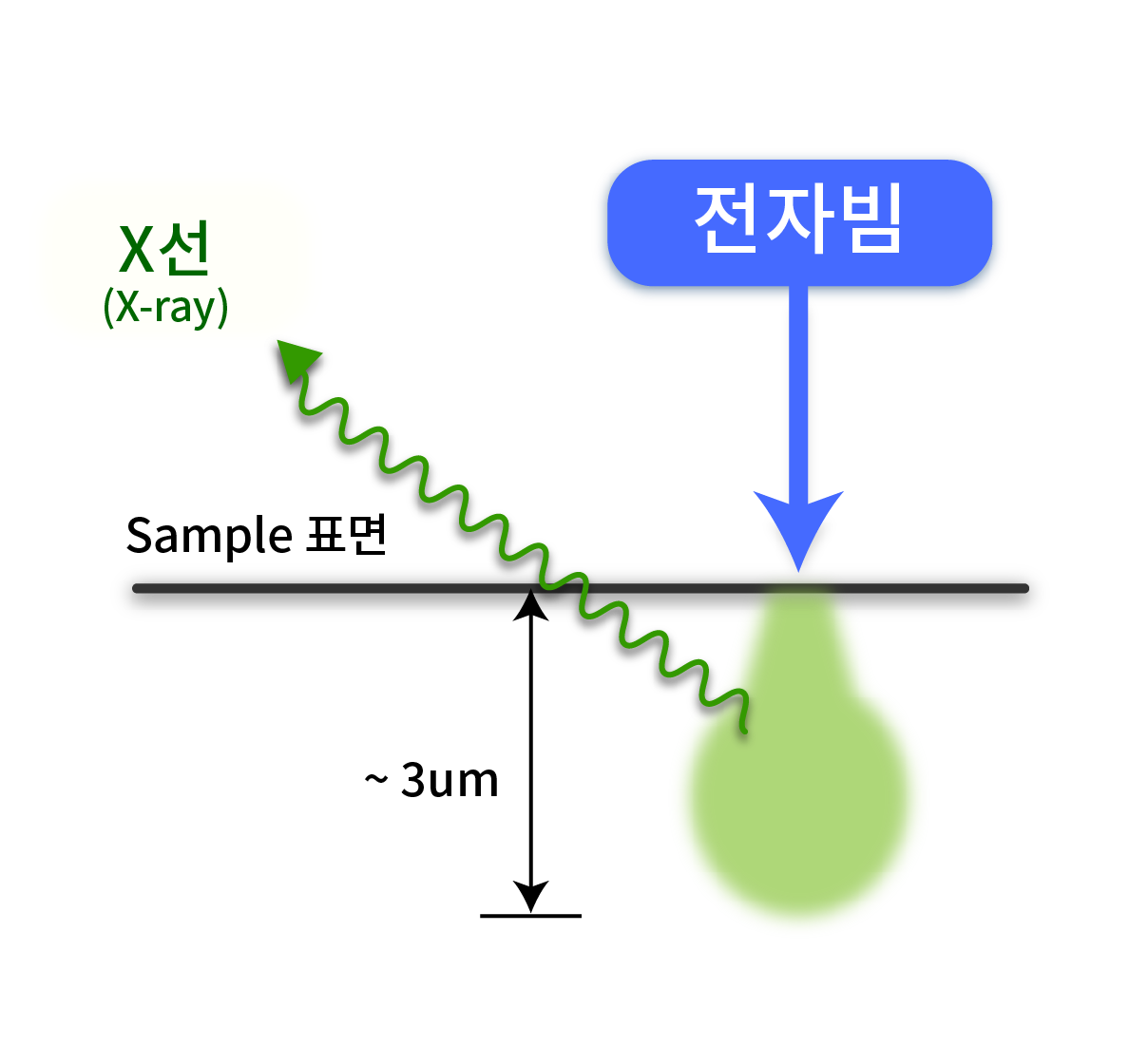
XPS의 X-ray 활용 원리
XPS는 X선을 시료에 조사했을 때 시료와 X선의 상호작용으로 발생하는 광전자를 분석합니다. 이때 EDS와 가장 큰 차이가 발생하게 되는데요. 바로 ‘분석 깊이’입니다.
이 분석 깊이는 광전자의 탈출 깊이와 관련이 있습니다. X선 또한 시료 표면에 입사하면 광범위하게 전자들과 상호작용을 합니다. 하지만 방출된 광전자는 시료 안쪽에서 빠져나오면서 다른 원자들과 충돌하며 그 에너지를 대부분 잃거나 흡수되게 됩니다.
따라서 실제로 분석기에 도달하는 광전자는 매우 얕은 깊이(1 ~ 10 nm 정도)에서 발생한 것만 도달할 수 있습니다. 정보의 깊이가 얕으므로 자연히 시료의 표면의 성분 정보만 얻게 됩니다.
X선으로 인한 전자의 발생
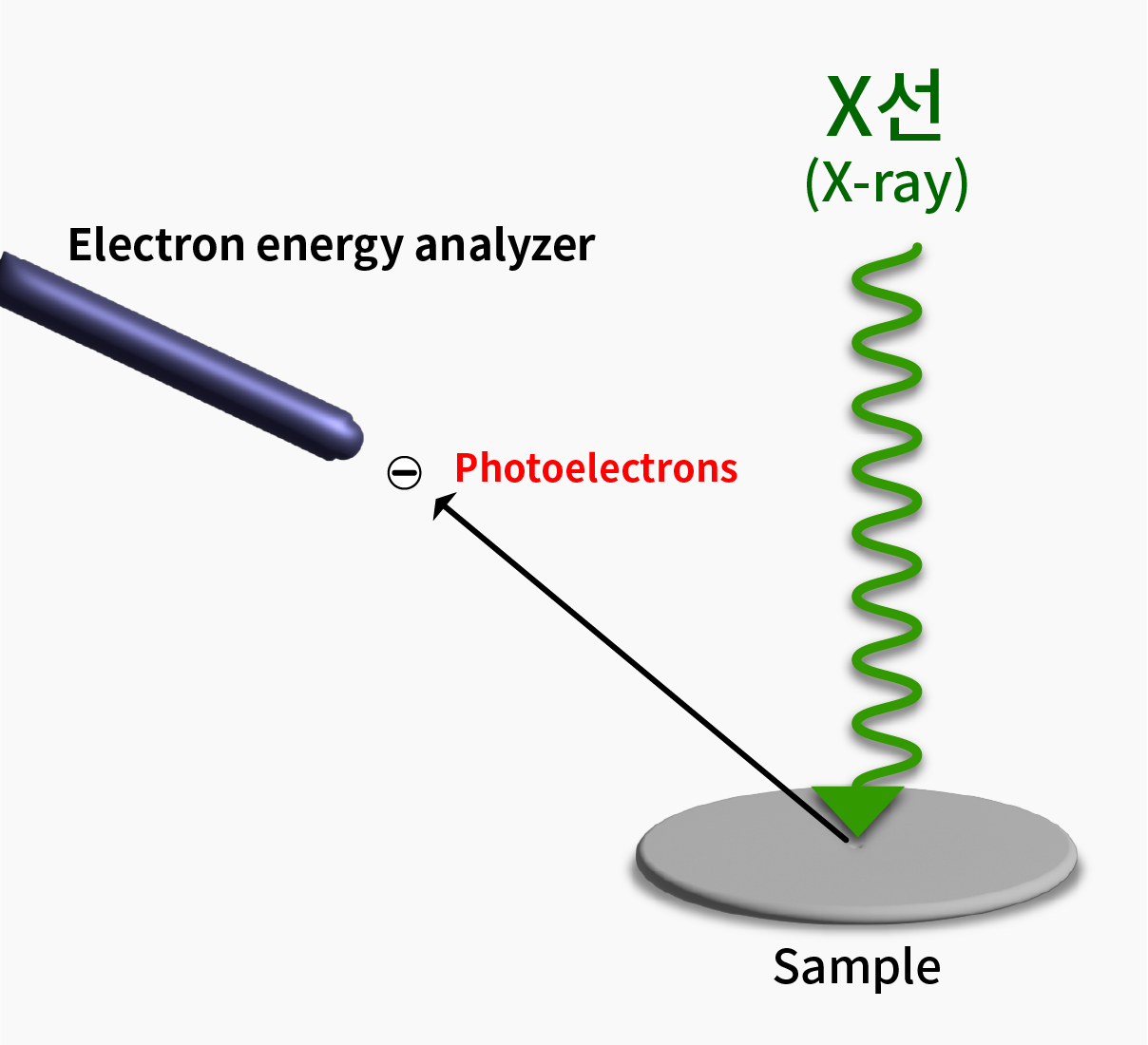
광전자의 탈출 깊이
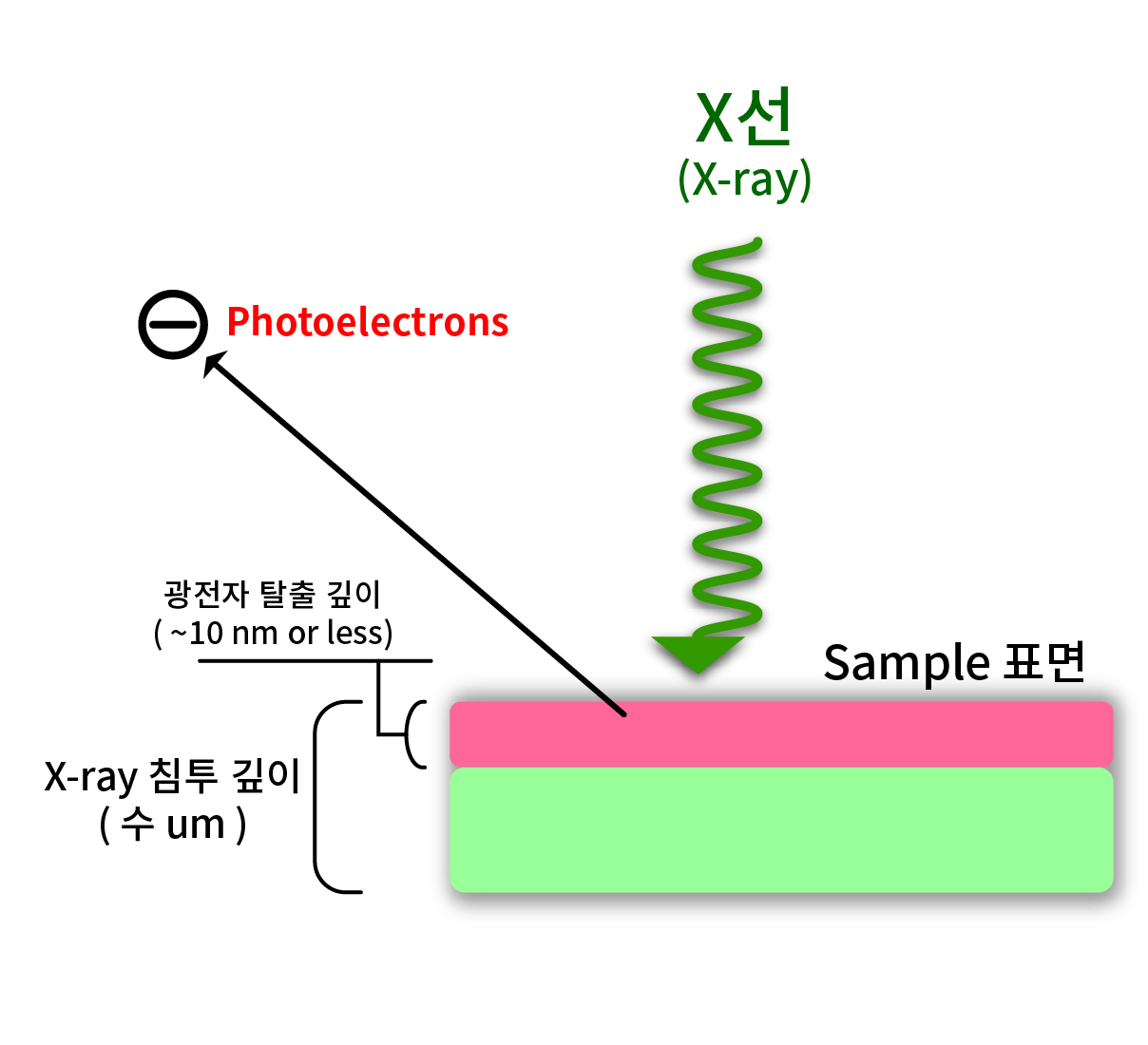
EDS와 XPS의 차이점 요약
XPS와 EDS는 원리부터 분석 범위까지 다른 부분이 많습니다. 이 차이를 비교하면 다음과 같이 정리할 수 있을 것 같습니다.
| 구분 | EDS (Energy Dispersive X-ray Spectroscopy) |
XPS (X-ray Photoelectron Spectroscopy) |
|---|---|---|
| 원리 | 시료에 전자빔을 조사하여 발생하는 X선을 분석 | 시료에 X선을 조사하여 방출된 광전자를 분석 |
| 분석 원소 범위 | B부터 U까지 분석 (주기율표 기준) |
Li부터 U까지 분석 (주기율표 기준) |
| 분석 위치 | 표면에서 약 3um 이하의 부피 | 시료의 표층 분석 |
| 분석 깊이 | 약 3 um 미만 | 약 1 ~ 10 nm |
| 핵심 분석 목적 | 원소의 검출 여부 및 시료 간의 농도 대소 비교 등 | 표면 성분의 정량 분석 등 |
| 장점 | 빠르고 이미지와 함께 분석 | 정밀한 표면 화학 정보 제공 |
| 단점 | 정량 분석에 한계가 있음 | 분석 시간이 길고 시료 전처리가 복잡함 |
이번 포스팅에서는 이렇게 두 가지 분석에 대해 정리를 해봤습니다. 분석 마다 특장점이 있기 때문에 어떤 분석이 더 좋다고는 말할 수 없고 연구 목적과 방향에 맞춰 적절한 분석 장비를 선택하는 것이 가장 합리적일 것 같습니다.
MCC의 분석 서비스가 궁금하다면?
더 유익한 분석 정보가 필요하다면?